- Плазменные процессы в технологии кремниевых ИС, исследуемые в лабораториях ФТИАН
- Широкоапертурный источник плотной плазмы
- Радиальные зависимости концентраций положительных ионов и электронов, электронной температуры в плазме BF3
- Травление кремния и других материалов на установке с широкоапертурным источником плотной плазмы
- Плазменно-иммерсионная ионная имплантация (ПИИИ)
- Особенности плазмоиммерсионной имплантации (BF3)
- Формирование суб-100 нм р-n переходов
- Установка для плазмостимулированного осаждения диэлектриков
- Плазмостимулированное осаждение SiO2 в тренчи (0,5х2 мкм) и частичная планаризация рельефа
- Мониторинг плазменных технологических процессов
- Новое поколение быстродействующих акусто-оптических спектрометров (ВНИИФТРИ)
- Мониторинг процесса формирования затвора МОП-транзистора методом АО-актинометрии
- Мониторинг травления структуры Si3N4(0.15мкм)/SiO2(0.3мкм)/Si методом АО-актинометрии
- Увеличение чувствительности спектральных методов для определения момента окончания процесса
- Диагностика плазмы в широкоапертурных источниках
- Томография источников плазмы на основе ОЭС (2D-распределения реактивных частиц, ионов)
- Плазмохимические модули в микроэлектронных производствах
- Резюме
(Лаборатория микроструктурирования и субмикронных приборов,
Зав.лабораторией академик А.А.Орликовский)
Плазменные процессы в технологии кремниевых ИС, исследуемые в лабораториях ФТИАН
- Травление кремния, кремнийсодержащих диэлектриков, металлов и т.д.
- Низкотемпературное нанесение диэлектриков
- Снятие фоторезиста (стриппинг)
- Стабилизация резиста
- Очистка поверхности пластин от органических загрязнений и атомов тяжелых металлов
- Частичная планаризация
- Ионная имплантация
ХАРАКТЕРИСТИКИ:
- Тип разряда: ВЧ-индуктивный с магнитным удержанием плазмы
- Генератор:13,56 МГц, до 3 кВт
- Диапазон рабочих давлений: 1×10-4 – 1×10-2 Торр
- Рабочие газы: H2, He, Ar, CxFy, SF6, O2, BF3
- Плотность плазмы (разряд в аргоне):3×1012 см-3 при 3×10-3 торр
- Температура электронов 4,25 эВ
- Возможность масштабирования
Конструкция реактора, фото на рисунке, включает ВЧ источник плазмы и держатель, предназначенный для размещения на нем пластины Ø 150 мм. Рабочая камера источника представляет собой цилиндр Ø 300 мм и высотой 200 мм, выполненный из нержавеющей стали. Магнитная система ВЧ источника ИВП построена с применением постоянных магнитов, изготовленных из сплава Nd-Fe-B.
В источнике достигнута высокая плотность плазмы и высокая радиальная однородность, низкая температура электронов, что иллюстрируется на рисунках, приведенных ниже.
Травление кремния и других материалов на установке с широкоапертурным источником плотной плазмы

Традиционные методы ионной имплантации становятся малопроизводительными в диапазоне энергий ионов ниже 5 кэВ, что связано с неизбежным падением тока пучка, формируемого ионной оптикой. Использование оксидных и резистивных масок для дополнительного торможения высокоэнергетичных ионов при ультрамелком легировании поверхностных областей кремния существенно усложняет технологию.
Альтернативным способом ультрамелкого легирования, позволяющим разрешить эту проблему, является метод широкоапертурной плазменно-иммерсионной ионной имплантации (ПИ3). В отличие от традиционных имплантеров, иммерсионный режим дает сокращение времени набора дозы в десятки раз с возможностью прецизионной регулировки энергии ионов в суб-1кэВ диапазоне. В то же время, отсутствие сепарации ионов по массам предъявляет повышенные требования к разработке конкретных процессов имплантации. Преимущества ПИИИ сводятся к следущим:
- Возможность создания р-n переходов с глубиной залегания 10-100 нм
- Возможность увеличения производительности процесса в десятки раз по отношению к традиционным имплантерам
- Стоимостные и массогабаритные показатели ПИИИ на порядок превосходят традиционные имплантеры
Со следующими характеристиками:
- Диаметр обрабатываемых пластин: 150-200 мм
- Плотность ионов в плазме (BF3): 5х1010-5х1011см-3
- Плотность ионного тока: 1-5 мА/см2
- Неоднородность плотности ионов на диаметре 150 мм: <2%
- Режим имплантации: импульсно-периодический
- Параметры импульсов смещения: длительность 1–20 мкс, частота 0.5–5 кГц,
- Амплитуда: -(0.2–5) кВ
- Время набора дозы: <1 мин.
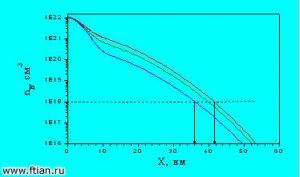
Распределения концентрации бора в зависимости от процентного содержания ионов BF2+ в общем потоке ионов: 50% – красн., 70% – зелен., 90% – синяя линии (расчет). Эксперименту соответствует зеленая линия.
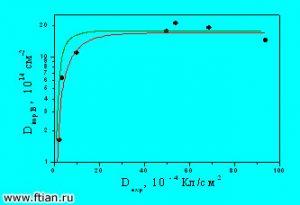
Одновременно с процессом имплантации в плазме BF3 радикалы фтора травят приповерхностный слой, что с увеличением дозы приводит к насыщению результирующей дозы.
Формирование суб-100 нм р-n переходов

(после отжига Т=850°С, t=15 мин)
Предаморфизация в плазме Хе, Р=1,1*10-1 Па, W=1250 Вт
Uсм=-3,75кВ, f=1 кГц, Iср=0,3 А, t=30 с.
Имплантация в плазме BF3, Р=2,7*10-2 Па, W=1250 Вт
Uсм=-3,75кВ, f=1 кГц, Iср=0,14 А, t=10 с.
Оценка дозы D=55*10-6 К/см2

Состав прототипа установки, разработанной ФТИАН:
- Плазменный источник с индуктивным возбуждением плазмы и магнитной системой для повышения плотности и однородности плазмы;
- Держатель с механическим прижимом пластины с подачей газообразного гелия под пластину для выравнивания радиального распределения температуры по пластине и улучшения ее теплового контакта с держателем;
- Вакуумная система (система откачки);
- Система газонапуска;
- ВЧ генератор с устройством согласования с индуктором возбуждения плазмы;
- ВЧ генератор с устройством согласования для подачи смещения на держатель пластины;
- Система контроля и поддержания температуры пластины;
- Шлюзовая камера для ручной загрузки пластин;
- Система мониторинга процесса осаждения методом многоканальной элипсометрии;
- Автоматизированная спектроскопическая система мониторинга компонентного состава плазмы;
- Система автоматического управления процессом осаждения и вспомогательными операциями (управление системой загрузки-выгрузки пластин, вакуумной системой, газовой системой, системой поддержания температуры пластины; генераторами мощности и смещения и остановка процесса);
- Стойка ручного управления.
Установка удовлетворяет следующим техническим требованиям:
Диаметр плазменного источника: не более 350 мм
Высота источника: не более 300 мм
Диаметр обрабатываемой пластины: 100 мм
Неоднородность плотности ионов на диаметре 100 мм: <±1%
Плотность ионного тока на пластине: 0,1–20 мА/см2
Рабочее давление:10-4–10-2 Topp
Остаточное давление:2×10-6 Topp
Тип высоковакуумного насоса, его производительность: Турбомолекулярный, не менее 750 л/с
Тип форвакуумного насоса, его производительность: Механический, не мене 14 л/мин
Рабочие газы: SiH4, O2, Не, гексаметилдисилозан тетраэтоксисилан, Аг и др.
Способ подачи газов: Газораспределительное кольцо
Количество каналов газонапуска и тип регуляторов расхода газа: 4, стандартный (РРГ – 6 или РРГ-3)
Магнитная система: Постоянные магниты из сплава Nd-Fe-B
Способ возбуждения плазмы: Безэлектродный разряд с ВЧ индуктивным возбуждением плазмы
Диапазон автоматического поддержания температуры пластины: 80-500°С
Точность поддержания температуры: Не хуже ±10°С
Разброс значений температуры по площади пластины на диаметре 90 мм в процессе осаждения: ±3%
Прижим пластины: Механический
Время загрузки (выгрузки) пластины: Не более 60 с.
Способ измерения толщины растущей пленки, тип прибора и его паспортное разрешение по толщине: Многоканальная элипсометрия; ЕК-70, 0.1 нм
Диапазон спектрометра: 300-800 нм
Спектральное разрешение: 0,15-0,35 нм
Максимальная скорость роста двуокиси кремния: Не менее 0,2 мкм/мин.
Смещение, подаваемое на держатель пластин: ВЧ-13,56 МГц, 0-500 Вт, возникающее при этом постоянное смещение должно лежать в диапазоне +20 + – 400 В
Конструкционные материалы вакуумного объема: Нержавеющая сталь, сверхчистая керамика, кварц, витон, медь
Масса: Не более 800 кг
Осаждение SiO2 окислением (CH3)6Si2O
W=1,5 кВт, Р=2х10-3 Торр, Ts=300K; O/Si=1,95-1,99;
Eпор=106 В/см;
Iут<10-10 A/см2; n=1,45±0,01
Неравномерность на 200 мм < 2%
Тренчи шириной 0,5 мкм и глубиной 1,5 мкм заполнялись диоксидом кремния, получаемым из процесса плазмохимического разложения гексаметилдисилоксана (ГМДС) с последующим окислением продуктов реакции на поверхности пластины.
Скорость заполнения при высоких аспектных соотношениях не превышала 0,1мкм/мин. Продемонстрировано сглаживание рельефа после заполнения тренчей и возможность планаризации поверхности после заполнения тренчей с высоким аспектным соотношением.
- Спектральные диагностические методы.
- Масс-спектрометрия in situ.
- Зондовые методы диагностики процессов травления.
- СВЧ-диагностика плазмы в качестве end-point детектора.
- Интерферометрические и эллипсометрические методы.
- Термометрия поверхности в диагностике плазменных процессов.
- Спектральный диапазон: 400-800 (300-855) нм
- Число независимых спектральных каналов: 1-4
- Спектральное разрешение: 0,15 – 0,3 нм
- Частицы в плазме, регистрация которых возможна использованием АОС
- Реактивные частицы: Cl*,Cl+, F*, Br*,Br+, O*, O2+, CF, CCl, H-продукты реакции:SiF*, CN*, CO, Al, Si, С2– газы-актинометры: N2, He, Ne, Ar, Kr, Xe
Мониторинг процесса формирования затвора МОП-транзистора методом АО-актинометрии
Мониторинг травления структуры Si3N4(0.15мкм)/SiO2(0.3мкм)/Si методом АО-актинометрии
Увеличение чувствительности спектральных методов для определения момента окончания процесса
Разностная схема для геликонных и ЭЦР –источников плазмы фазового детектирования для ICP/TCP – источников плазмы
В основе предложенного нами метода спектрального синхронного детектирования лежит тот факт, что полезный сигнал эмиссии ХАЧ неизбежно оказывается модулирован частотами, присутствующими в генераторе плазмы. В НЧ-генераторах плазмы глубина модуляция оптической эмиссии достигает 100 %. Используя частоту модуляции генератора плазмы как опорную для фазового детектора, входной измеренный сигнал оптической эмиссии, пришедший в фазе с опорным, демодулируется по отношению к этой частоте. Все сигналы некогерентные с опорным, резко ослабляются. Поэтому проверка гипотезы о положительном эффекте синхронного детектирования спектрального сигнала проводилась на НЧ-реакторе, имеющем максимальную глубину модуляции разряда. Блок-схема модифицированной установки спектрального мониторинга с фазовым детектированием показана на рисунке. Она включает в себя спектрометр, систему выделения сигнала и саму установку ПХТ.
Спектральный анализ эмиссионного сигнала плазмы проводился скоростным акустооптическим спектрометром “Кварц-4М”, состоящим из фотоприемной головки и электронного блока обработки сигнала, совмещенного с управляющим компьютером. Для выделения из шумов преобразованного фотоголовкой сигнала эмиссионных линий плазмы применен фазовый детектор “Unipan 232B” с предварительной фильтрацией исследуемого сигнала полосовым фильтром “Unipan 233”. Подключение фазового детектора к используемому спектрометру, с целью сохранения режимов работы электронных блоков последнего, осуществлялось через разработанное устройство согласования.
Для распространенных в настоящее время ВЧ- (13,56 МГц) и СВЧ- (2.45 ГГц) плазменных реакторов необходимо вводить низкочастотную модуляцию генераторов, сигнал которой и будет опорным для синхронного детектирования.
Автоматизированный диагностический комплекс:
- автоматизированная оптическая эмиссионная спектрометрия для определения состава плазмы
- автоматизированные измерения плотности плазмы, температуры электронов и равномерности потока ионов с пространственным разрешением
- Синхронный двухканальный спектрометр для регистрации эмиссионного излучения активных радикалов и ионов во F-, Cl-и Br-содержащей плазме по двум независимым каналам,
- Система автоматизированного сканирования оптических детекторов по двум координатам,
- Комплект программного обеспечения управления томографом,
- Пакет специализированных программ компьютерной томографии
Продольное распределение плотности частиц в плазме вдоль поверхности пластины является критическим для плазменных процессов на стадии производства интегральных схем, и должно быть оптимизировано на этапе разработки процесса. Оптическая эмиссионная томография плазмы является многообещающим методом для этой цели.
Разработаны масштабируемые широкоапертурные источники плотной плазмы и конструкции плазменных установок на их основе, разработаны плазменные глубоко субмикронные процессы травления, осаждения, частичной планаризации, имплантации, стабилизации и удаления резиста, очистки поверхности пластин и др.
Разработаны методы мониторинга плазменных процессов и аттестации источников плазмы применением только отечественных диагностических средств: оптических эмиссионных спектрометров (ВНИИФТРИ) и спектроэллипсометров (ИРЭ РАН)
На основе выполненных разработок возможно создание промышленного оборудования как кластерного, так и модульного типов для отечественных глубоко субмикронных производств.